Powody i sposoby użycia tranzystorów GaN FET w wysokosprawnych, wysokonapięciowych zastosowaniach zasilania impulsowego
Przekazane przez: Północnoamerykańscy redaktorzy DigiKey
2023-01-26
Sprawność energetyczna jest priorytetem w systemach elektronicznych w obliczu zarówno wymogów społecznych, jak i regulacyjnych. Sprawność konwersji mocy i gęstość mocy mają kluczowe znaczenie dla powodzenia projektów, w szczególności w przypadku zastosowań takich jak pojazdy elektryczne (EV), komunikacja wysokiego napięcia oraz infrastruktura przemysłowa.
Aby spełnić te wymagania, projektanci systemów zasilania impulsowego muszą odejść od klasycznych tlenkowo-metalowych tranzystorów (MOSFET) opartych na krzemie (Si) i tranzystorów bipolarnych z izolowaną bramką (IGBT), ponieważ szybko zbliżają się one do swoich teoretycznych limitów.
Zamiast tego projektanci muszą rozważyć urządzenia oparte na materiałach półprzewodnikowych o szerokiej przerwie energetycznej, takich jak azotek galu (GaN). Urządzenia na bazie azotku galu przełączają się szybciej niż urządzenia oparte na krzemie, radzą sobie z wyższymi poziomami napięcia i mocy, są znacznie mniejsze dla danego poziomu mocy i działają ze znacznie wyższą sprawnością.
W niniejszym artykule omówiono podstawy tranzystorów GaN FET, przedstawiono ich zalety w porównaniu z tradycyjnymi tranzystorami krzemowymi w obwodach zasilania impulsowego, przedstawiono rzeczywiste przykłady firmy Nexperia i przedyskutowano ich zastosowanie.
Podstawy tranzystorów GaN FET
Podstawowymi elementami obwodów konwersji mocy są wysokonapięciowe przełączniki półprzewodnikowe. Projektanci skupili się na poprawie wydajności tych urządzeń poprzez: zmniejszenie strat przewodzenia dzięki zmniejszeniu rezystancji szeregowej w stanie włączenia, zmniejszenie strat przełączania dzięki zwiększeniu prędkości zmiany stanów i zmniejszenie efektów pasożytniczych. Ogólnie rzecz biorąc, te starania projektowe przyniosły sukces w przypadku krzemowych tranzystorów MOSFET i tranzystorów IGBT, ale tempo poprawy spowalnia, gdy działanie tych urządzeń osiąga swoje teoretyczne granice.
W rezultacie w ciągu ostatnich kilku lat wprowadzono urządzenia wykonane z półprzewodników o szerokiej przerwie energetycznej (WBG) wykorzystujące węglik krzemu (SiC) i azotek galu (GaN) w stopniu umożliwiającym produkcję seryjną. Urządzenia te oferują wyższe zakresy napięć roboczych, krótsze czasy przełączania i wyższą sprawność.
Przerwa energetyczna półprzewodnika to minimalna energia, która jest wymagana do wzbudzania elektronów w celu ich oswobodzenia ze stanu związania do stanu swobodnego w celu przewodzenia energii elektrycznej (tabela 1).
|
Tabela 1: zestawienie kluczowych właściwości, które odróżniają półprzewodniki o szerokiej przerwie energetycznej, takie jak azotek galu (GaN) i węglik krzemu (SiC) od krzemu (Si). (Źródło tabeli: Art Pini)
Urządzenia wykonane z użyciem półprzewodników o szerokiej przerwie energetycznej mogą pracować przy znacznie wyższych napięciach, częstotliwościach i temperaturach niż urządzenia z konwencjonalnych materiałów półprzewodnikowych, takich jak krzem (Si). Szersza przerwa energetyczna jest szczególnie ważna dla umożliwienia pracy urządzeń w znacznie wyższych temperaturach. Wysoka tolerancja temperaturowa oznacza, że w normalnych warunkach urządzenia te mogą być eksploatowane przy znacznie wyższych poziomach mocy. Półprzewodniki o szerokiej przerwie energetycznej (WBG) o większym krytycznym polu elektrycznym i większej ruchliwości charakteryzują się najniższą rezystancją dren-źródło w stanie włączenia (RDS(ON)), co zmniejsza straty przewodzenia.
Większość materiałów o szerokiej przerwie energetycznej charakteryzuje się również wysokimi prędkościami wolnych elektronów, co pozwala im pracować z większą prędkością przełączania.
W porównaniu z krzemem (Si), który ma przerwę energetyczną 1,12eV, azotek galu (GaN) i węglik krzemu (SiC) są związkami półprzewodnikowymi o przerwach energetycznych około trzy razy większych - odpowiednio 3,4eV i 3,3eV. Oznacza to, że oba materiały mogą obsługiwać wyższe napięcia i wyższe częstotliwości.
Wyższa ruchliwość elektronów w azotku galu (GaN) sprawia, że jest on o wiele bardziej odpowiedni do zastosowań o wysokich parametrach działania i wysokiej częstotliwości. Wyższe prędkości przełączania i wyższe częstotliwości robocze możliwe dzięki tranzystorom GaN FET skutkują lepszą kontrolą sygnału, pasywnymi filtrami o wyższych częstotliwościach odcięcia oraz niższymi prądami tętniącymi. Pozwala to na stosowanie mniejszych cewek indukcyjnych, kondensatorów i transformatorów, co przekłada się na zmniejszenie całkowitej wielkości i ciężaru urządzenia.
Tranzystory GaN FET są nazywane tranzystorami o wysokiej ruchliwości elektronów (HEMT). Wysoka ruchliwość elektronów jest funkcją struktury tranzystora polowego (FET) (ilustracja 1).
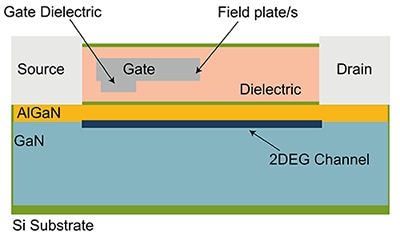 Ilustracja 1: przekrój poprzeczny tranzystora GaN FET bazującego na podłożu krzemowym. (Źródło ilustracji: Nexperia)
Ilustracja 1: przekrój poprzeczny tranzystora GaN FET bazującego na podłożu krzemowym. (Źródło ilustracji: Nexperia)
Do produkcji tranzystorów GaN FET wykorzystuje się istniejące zakłady produkcyjne krzemowych komplementarnych półprzewodników tlenkowych (CMOS), co zapewnia opłacalność. Warstwa azotku galu powstaje na podłożu krzemowym poprzez osadzanie warstwy zaszczepiającej i warstwy gradientowej azotku galu (GaN) oraz azotku galowo-glinowego (AlGaN) jako warstwy izolacyjnej (nie pokazano na ilustracji) przed utworzeniem się czystej warstwy GaN. Druga warstwa azotku galowo-glinowego (AlGaN) jest nałożona na wierzchu warstwy azotku galu (GaN). Powoduje to polaryzację piezoelektryczną, z nadmiarem elektronów generowanym bezpośrednio poniżej azotku galowo-glinowego (AlGaN), czyli w kanale o wysokiej przewodności. Ten nadmiar elektronów jest znany jako dwuwymiarowy gaz elektronowy (2DEG). Nazwa odzwierciedla bardzo wysoką ruchliwość elektronów w tej warstwie.
Pod bramką tworzy się obszar zubożony. Działanie bramki jest podobne do tranzystora mocy MOSFET z kanałem N ze wzbogaceniem. Dodatnie napięcie przyłożone do bramki tego urządzenia powoduje jego włączenie.
Omawiana struktura jest powtarzana wielokrotnie w celu utworzenia urządzenia mocy. Efektem końcowym jest zasadniczo proste, eleganckie i opłacalne rozwiązanie do przełączania mocy.
Aby uzyskać urządzenie o wyższym napięciu, zwiększa się odległość między drenem a bramką. Ponieważ rezystywność dwuwymiarowego gazu elektronowego (2DEG) w azotku galu (GaN) jest bardzo niska, wpływ na rezystancję poprzez zwiększenie wytrzymałości na napięcie blokujące jest znacznie niższy w porównaniu z urządzeniami krzemowymi.
Tranzystory GaN FET mogą być skonstruowane tak, aby działały w jednej z dwóch konfiguracji: z kanałem wzbogaconym lub z kanałem zubożonym. Tranzystory polowe (FET) z kanałem wzbogaconym są normalnie wyłączone, więc w celu ich włączenia do bramki należy przyłożyć napięcie dodatnie względem drenu/źródła. Tranzystory polowe (FET) z kanałem zubożonym są normalnie włączone, więc w celu ich wyłączenia do bramki należy przyłożyć napięcie ujemne względem drenu/źródła. Tranzystory polowe (FET) z kanałem zubożonym stwarzają problemy w układzie zasilania, ponieważ przed włączeniem zasilania systemu konieczne jest przyłożenie ujemnego napięcia polaryzacji do tranzystora GaN FET z kanałem zubożonym.
Jednym ze sposobów obejścia tego problemu jest użycie połączenia kaskodowego niskonapięciowego krzemowego tranzystora polowego (FET) i tranzystora GaN FET z kanałem zubożonym (ilustracja 2).
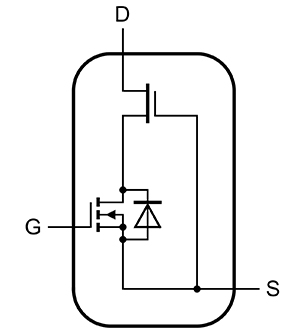 Ilustracja 2: niskonapięciowy krzemowy tranzystor MOSFET w konfiguracji kaskodowej z tranzystorem GaN FET z kanałem zubożonym zapewnia wytrzymałość struktury bramki krzemowej z ulepszoną charakterystyką wysokonapięciowego taktowania urządzenia wykorzystującego azotek galu (GaN), a w przypadku tranzystora GaN FET z kanałem zubożonym - także wyłączenia urządzenia złożonego w momencie włączenia zasilania. (Źródło ilustracji: Nexperia)
Ilustracja 2: niskonapięciowy krzemowy tranzystor MOSFET w konfiguracji kaskodowej z tranzystorem GaN FET z kanałem zubożonym zapewnia wytrzymałość struktury bramki krzemowej z ulepszoną charakterystyką wysokonapięciowego taktowania urządzenia wykorzystującego azotek galu (GaN), a w przypadku tranzystora GaN FET z kanałem zubożonym - także wyłączenia urządzenia złożonego w momencie włączenia zasilania. (Źródło ilustracji: Nexperia)
Obwód kaskodowy wykorzystuje strukturę bramki krzemowego tranzystora MOSFET, która oferuje zalety wyższych wartości granicznych sterowania bramki dopasowanych do istniejących układów scalonych sterowników bramek MOSFET, a tranzystor GaN FET z kanałem zubożonym jest wyłączony w momencie włączenia zasilania.
Jedną z kluczowych cech tranzystorów GaN FET jest ich wysoka sprawność. Wynika to z niskiej rezystancji szeregowej obniżającej straty przewodzenia, z krótszych czasów przełączania obniżających straty przełączania oraz z niższego ładunku regeneracji wstecznej obniżającego straty regeneracji wstecznej.
Wykorzystując powszechnie znaną topologię półmostkowej przetwornicy podwyższającej, można porównać sprawność tranzystorów GaN FET i krzemowych tranzystorów MOSFET (ilustracja 3).
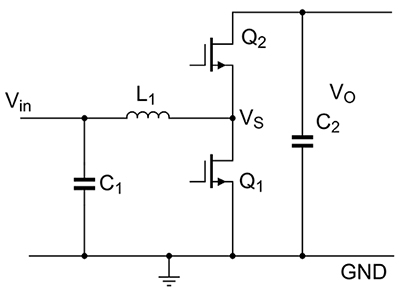 Ilustracja 3: schemat półmostkowej przetwornicy podwyższającej, służący do porównywania sprawności tranzystorów MOSFET i GaN FET poprzez wymianę tranzystorów Q1 i Q2 na poszczególne typy urządzeń. (Źródło ilustracji: Nexperia)
Ilustracja 3: schemat półmostkowej przetwornicy podwyższającej, służący do porównywania sprawności tranzystorów MOSFET i GaN FET poprzez wymianę tranzystorów Q1 i Q2 na poszczególne typy urządzeń. (Źródło ilustracji: Nexperia)
Przetwornica podwyższająca ma napięcie wejściowe 240V, wyjściowe 400V i częstotliwość przełączania 100kHz. Sprawność i straty są porównywane w zakresie mocy do 3500W (ilustracja 4).
 Ilustracja 4: porównanie sprawności i strat mocy między tranzystorami GaN FET i tranzystorami MOSFET w identycznym obwodzie, ukazujące zalety tranzystorów Gan FET. (Źródło ilustracji: Nexperia)
Ilustracja 4: porównanie sprawności i strat mocy między tranzystorami GaN FET i tranzystorami MOSFET w identycznym obwodzie, ukazujące zalety tranzystorów Gan FET. (Źródło ilustracji: Nexperia)
Tranzystory GaN FET charakteryzują się o około 20% wyższą sprawnością w porównaniu z tranzystorami MOSFET oraz około trzykrotnie niższymi stratami mocy. Przy mocy 2000W straty w tranzystorach MOSFET wynoszą około 62W, natomiast w tranzystorach GaN FET tylko 19W. Oznacza to, że układ chłodzenia może być mniejszy, co poprawia sprawność wolumetryczną przetwornicy podwyższającej.
Mniej oczywiste jest, że pomiar został przeprowadzony przy mocy prawie 3500W dla tranzystora GaN FET ze względu na jego wyższą wartość graniczną napięcia maksymalnego. W związku z tym tranzystor GaN FET ma zdecydowaną przewagę.
Rozpoczęcie pracy z azotkiem galu dla wyższych napięć
W sytuacjach wymagających wyższego napięcia firma Nexperia oferuje dwa tranzystory GaN FET 650V: GAN063-650WSAQ oraz GAN041-650WSBQ. Oba są tranzystorami polowymi z kanałem N, które są normalnie wyłączone. Tranzystor GAN063-650WSAQ jest przystosowany do pracy z maksymalnym napięciem dren-źródło 650V i może wytrzymywać napięcia w stanie nieustalonym (o szerokości impulsu poniżej mikrosekundy) 800V. Jego znamionowy prąd drenu wynosi 34,5A, natomiast straty mocy przy temperaturze 25°C wynoszą 143W. Rezystancja dren-źródło w stanie włączenia wynosi typowo 50mΩ, a jej maksymalna wartość graniczna wynosi 60mΩ.
Tranzystor GAN041-650WSBQ ma takie samo maksymalne napięcie znamionowe dren-źródło 650V oraz tę samą wartość graniczną napięcia w stanie nieustalonym 800V. Różni się tym, że może obsłużyć maksymalny prąd drenu 47,2A i maksymalne straty mocy 187W w temperaturze pokojowej. Jego typowa rezystancja kanału wynosi 35mΩ, natomiast rezystancja maksymalna 41mΩ.
Projekt referencyjny firmy Nexperia wykorzystujący tranzystor GAN063-650WSAQ w konfiguracji półmostkowej przedstawiono na ilustracji 5.
 Ilustracja 5: zalecany projekt półmostkowego stopnia mocy wykorzystujący tranzystor GaN FET GAN063-650WSA. Schemat przedstawia tylko sterownik tranzystora polowego (FET) i półmostkowy stopień wyjściowy oraz powiązane komponenty. (Źródło ilustracji: Nexperia)
Ilustracja 5: zalecany projekt półmostkowego stopnia mocy wykorzystujący tranzystor GaN FET GAN063-650WSA. Schemat przedstawia tylko sterownik tranzystora polowego (FET) i półmostkowy stopień wyjściowy oraz powiązane komponenty. (Źródło ilustracji: Nexperia)
Na schemacie przedstawiono podwójny izolowany sterownik bramek strony wysokiej/niskiej Si8230, który służy do sterowania bramkami tranzystorów GaN FET. Wyjście sterownika bramek jest połączone z bramką za pośrednictwem rezystora bramkowego 30Ω, który jest wymagany dla wszystkich urządzeń wykonanych na bazie azotku galu (GaN). Rezystor bramki kontroluje czas ładowania pojemności bramki, wpływając na parametry dynamiczne przełączania. Układy R-C między drenem a źródłem tranzystora polowego (FET) również pomagają w kontrolowaniu parametrów przełączania. Poziomy sterowania bramką dla tranzystora GaN FET wynoszą od 0 do 10/12V.
Wysoka prędkość przełączania w tranzystorach GaN FET (zazwyczaj w zakresie od 10 do 11ns) wymaga starannego rozmieszczenia komponentów w celu zminimalizowania indukcyjności pasożytniczych oraz zastosowania tłumików RC w celu zmniejszenia oscylacji komutacyjnych spowodowanych stanami nieustalonymi napięcia i prądu. W omawianym projekcie między zasilaniem wysokiego napięcia a masą znajduje się wiele tłumików RC (od R17 do 19 oraz od C33 do 35). Tłumiki redukują oscylacje komutacyjne spowodowane interakcją tranzystora GaN FET z układem obejściowym. Tłumiki powinny być podłączone możliwie najbliżej drenu tranzystora polowego (FET) po stronie wysokiej. Są one realizowane z użyciem rezystorów do montażu powierzchniowego i kondensatorów ceramicznych o niskiej równoważnej rezystancji szeregowej (ESR), aby zminimalizować indukcyjność odprowadzeń.
Układ tworzony przez komponenty R4, D1, C12 oraz C13 stanowi zasilacz typu bootstrap dla sterownika bramek po stronie wysokiej. Komponent D1 powinien być szybką diodą o niskiej pojemności, ponieważ pojemność jej złącza przyczynia się do strat przełączania. Komponent R4 ogranicza prąd początkowy ładowania. Dobrze sprawdza się wartość w zakresie od 10 do 15Ω.
Podsumowanie
Potrzeba wyższej sprawności konwersji mocy i gęstości mocy w różnych zastosowaniach, od pojazdów elektrycznych po infrastrukturę komunikacyjną i przemysłową, wymaga porzucenia klasycznych projektów na bazie krzemu. Tranzystory GaN FET stanowią drogę do rozwoju nowej generacji projektów, oferując wyższe napięcia robocze, krótsze czasy przełączania i wyższe sprawności. Gotowe komponenty, wspierane w niektórych przypadkach projektami referencyjnymi, pomagają projektantom w szybkiej realizacji projektów.

Disclaimer: The opinions, beliefs, and viewpoints expressed by the various authors and/or forum participants on this website do not necessarily reflect the opinions, beliefs, and viewpoints of DigiKey or official policies of DigiKey.